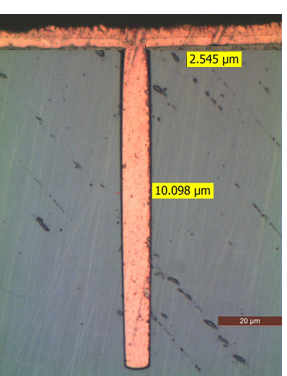
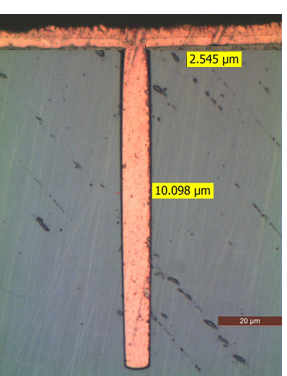
硅通孔光剂 RS-TSV
高深径比硅通孔超填电镀工艺
0.00
0.00
高深径比硅通孔超填电镀工艺
RS-TSV 是一种甲基磺酸镀铜工艺,可填充具有高纵横比的硅通孔 (TSV),而不会产生空隙和其他缺陷。 该工艺专适用的硅通孔直径范围为 5 至 100微米。配合在线添加剂药水浓度检测和管控,工艺稳定牢靠。
电镀参数:
| 参数名称 | 最优值 | 范围 |
| 甲基磺酸铜 (g/L) | 320 | 300~340 |
| 甲基磺酸 (g/L) | 20 | 15~25 |
| 氯离子 (ppm) | 50 | 30~60 |
| 光亮剂 RS-TSV B (ml/L) | 6 | 5~9 |
| 抑制剂 RS-TSV C (ml/L) | 7 | 3~8 |
| 整平剂 RS-TSV A (ml/L) | 5 | 3~18 |
| 电镀温度 (oC) | 25 | 22~28 |
电镀填充示例:
| 孔尺寸 | 电镀步骤一 | 电镀步骤二 | |||
| 直径 | 深度 | 电流密度 | 电镀时间 | 电流密度 | 电镀时间 |
| 30 ~ 100 微米 | 200 微米 | 0.5 ASD | 2 小时 | 1.0 ASD | 1.5 小时 |
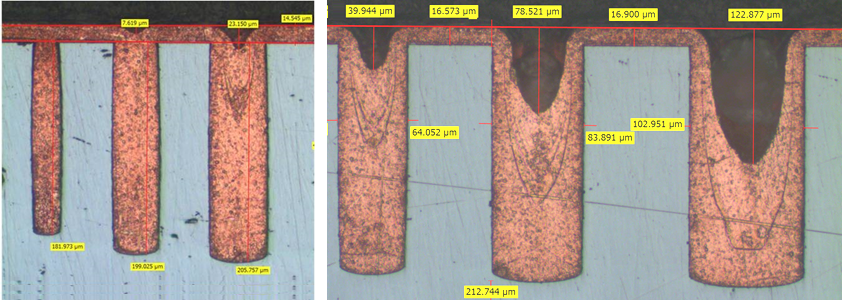
附注:
操作参数的进一步优化将取决于电镀槽设计、用户规格和集成要求。 种子层工艺、镀槽流体动力学、是否使用阳极隔膜以及随后的电镀后集成步骤等因素将决定最终的工艺参数。 建议每天进行放液和加液以保持电镀液的稳定状态。





