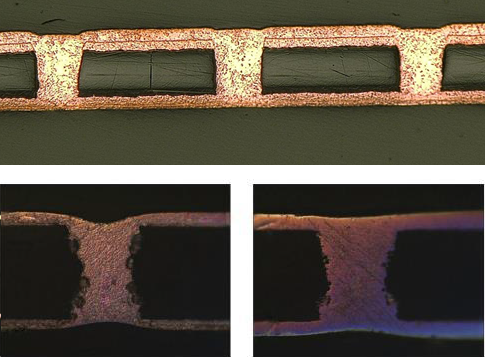
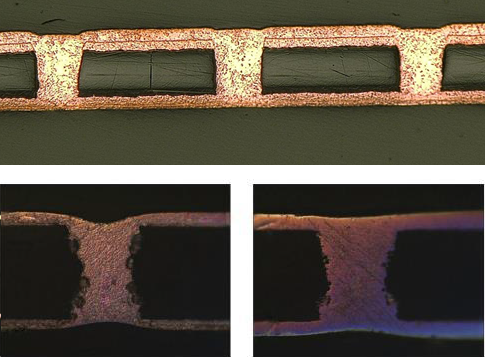
整平剂 RS-VLA
填孔用酸铜电镀光剂工艺
0.00
0.00
填孔用酸铜电镀光剂工艺
本工艺添加剂适用于HDI印刷电路板(包括全板电镀和图形电镀)上细微线路的形成、多层线路板制造及各种几何图形的盲孔通孔填充。该电镀工工艺镀层均匀、细致、无麻点,具有良好外观的光亮度。本工艺中采用的添加剂可以以电化学循环伏安分析方法(CVS: Cyclic Voltammetric Stripping)检测其在镀液中的浓度。
填孔能力:
直径 (um) | 板厚(um) | 填孔时间 | 面铜厚度(um) |
75 | ≦50 | 35min | ≦10 |
100 | 50~100 | 35~45min | ≦15 |
125 | 75~100 | 40~50min | ≦17 |
150 | 75~100 | 50~60min | ≦20 |
电镀药液组成:
成分 | 标准浓度 | 浓度范围 |
硫酸铜 CuSO4∙5H2O (g/L) | 220 | 200~240 |
硫酸 H2SO4 (g/L) | 40 | 30~50 |
氯离子 HCl (mg/L) | 40 | 30~50 |
抑制剂 RS-VLC (mL/L) | 10 | 7~15 |
加速剂 RS-VLB (mL/L) | 1 | 0.7~1.5 |
整平剂 RS-VLA (mL/L) | 15 | 7~20 |
电镀参数:
标准 | 范围 | |
阳极电流密度(ASD) | - | 1~2 |
阴极电流密度(ASD) | 1.8 | 1~2.5 |
浴温 (℃) | 25 | 20~28 |
搅拌 | 空气搅拌或喷流搅拌,两种搅拌同时用更好。 | |
过滤 | 连续过滤 | |





